- 今年连接器市场值将重回金融海啸前高峰水平
- 未来将向FEC、IC封装微型化等五大方向发展
- 2010年全球连接器市场值将达到498亿美元
一、前言
2010年初虽遇到缺工缺料、南欧主权债信风暴的局部干扰,却未影响全球连接器市场稳健复苏的脚步,而且在走出金融海啸困局后,世界领导厂商也更积极地投入产品技术的革新,期望能透过各种技术面的创新,重塑更强的市场成长动能。
鉴于此,本文将就2010年全球连接器市场与技术发展趋势进行分析,并归纳出未来产品技术面的整体发展方向:
二、2010年全球连接器市场值将重回金融海啸前高峰水平
2008年Q4~2009年上半金融海啸袭击全球,全球受创严重,使整体连接器市场值由2008年439亿美元下滑至2009年374亿美元,衰退幅度达-14.8%(见图一)。
2009年下半年4C应用市场稳定复苏,使连接器产业大体回到正常成长轨道,2010年初虽有缺工缺料、南欧主权债信因素产生少许干扰,但并未影响整体产业稳健成长的大趋势,除5月欧洲笔电拉货趋缓小幅影响连接器出货动能外,6、7月全球市况已转趋稳定,且随着智能型手机、LED TV、电子书、平板电脑等新兴应用相继问世,也可望带动连接器全年产值重回金融风暴前高峰,估计2010年全球连接器市场值将达到498亿美元历史新高。

金融风暴过后,连接器产品技术革新仍持续推进,以下将由设计、制造、封装/组装三大构面探讨连接器技术层面的发展趋势(见图二):
(一)设计趋势
1.系统设计的与时俱进,将带动连接器设计采用更多新材料与新功能。
2.芯片设计迈向SoC,将驱使连接器走向小型化并具备更高的电气效能。
3.封装趋势与产业标准将持续大幅影响连接器设计。
4.传统连接器在密耳接头会有实体设计上的限制,包括针对不同应用易损坏、难制造¼等障碍仍有待克服。
5.200~300 microns的连接器间距已接近传统技术极限,必须另寻小型化的关键技术。
6.光纤连接器开始兴起,并在效能上明显凌驾铜连接器。
7.IC设计与仿真软件逐渐成为连接器发展的影响要素之一。
(二)制造趋势
1.模件组装:当开发中国家制造基础建设趋于成熟时,将无可避免走向更高度的自动化。
2.Lights out Automation:近年来连接器的产品生命周期与毛利率日益受到压缩,因此设备生产走向自动化已成大势所趋,但即便如此,目前有经验之在线操作员与技术支持仍相对不足。
(三)封装趋势
1.针对先进区数组表面黏着(SMT)技术应用的附加BGA封装将成主流技术之一。
2.10~40Gbps和高密度的背板连接器大于或等于100每英吋讯号接触(signal contacts per inch),同时满足差动或单端讯号应用,或满足USB3.0、PCI-Express等低pin脚数的串行接口将快速增加。
3.高速同轴缆线和主动/固定式FO Cable组装将与日俱增。
4.针对IC测试的Socket将逐渐转向Wafer scale的制程。
5.高效能的内存插槽(如DIMM Socket)应用将与日俱增。
6.光学连接,如板级的光波封装在未来的设备设计上会日渐重要。
7.加值的连接器组装将可降低系统的成本与复杂性,并有助于次系统的委外代工。
8.低成本的线对板连接器和小尺寸的设计在3C汇流趋势下需求将日益提高。
9.SoC设计兴起也将连带影响电路板设计。
10.采用先进电子材料(如奈米材料)、并搭配部份微机电技术将成重要材料技术选项之一。
11.micro-printed电子、SoC和HDI载板的普及化,将使连接器迈向100mm范围,并使用更多additive/subtractive化学辗磨制程。
(四)2009年Imemi技术蓝图
1.连接器发展条件:尺寸更小、密度更高、效能更高。
2.半导体组件创新与电路整合规模攸关连接器发展走向。
举例而言,SoC趋势将影响分离式组件数目,意味每个系统的连接器数目将减少,同时内部系统组装的需求也将减少,并增加更多可配置化的密封盒,而当前可携式行动装置多已采用SiP与SoC方式,此种系统单芯片整合方式也将配置更多无线I/O到Silicon中,并搭配更多小型外部电路,而SiP也将带动更多HDI载板的的使用。
3.材料与开模:散热与微型化封装议题逐渐受到重视,材料技术多由日立、Honeywell等3rd Party负责,且在连接器产品技术演进过程中,几何成形(fine geometric molding)与嵌件成形(insert molding)技术将逐渐受到瞩目。
4.组装和封装:卷带式和托盘式封装日益普及。
5.表面黏着组装需要无铅焊锡材料:对于LED、电容等关键组件而言,更高的金属溶化温度变得日益重要,因应此一潮流,便需要在压缩封装材料与多阶段(multi-stage)焊锡组装技术上有所突破,藉此进一步满足RoHS/WEEE的绿色规范。
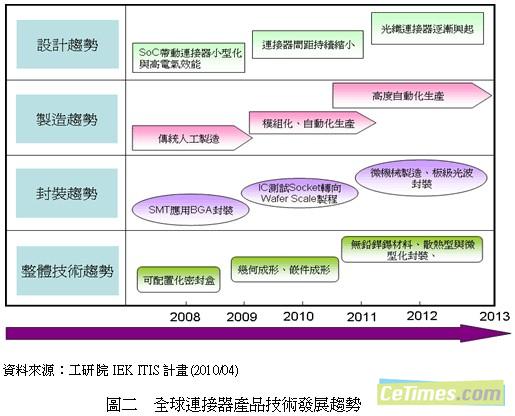
综上所述,可以得知未来全球连接器产品技术发展主要来自以下五个方向:
(一)FEC、IC封装皆将走向微型化:密度低于200mm间距。
(二)匹配高带宽与高速电路:因应各种高速传输接口应运而生。
(三)Power+ Thermal:确保峰值电流模式的维持。
(四)环保材料:无铅、无卤材料与奈米材料将广泛被采用。
(五)制程:基准型组装将日趋普及。
(六)设计自动化:更多新的IC设计电子自动化工具被采用后,将进一步影响未来连接器的数量与设计方向。



