【导读】对于声表面波器件来说,对温度非常敏感。在较高温度下,衬底材料的硬度易于下降,声波速度也因此下降。由于保护频带越来越窄,并且消费设备的指定工作温度范围较大(通常为-20℃至85℃),因此这种局限性的影响越来越严重。
一、TC-SAW
对于声表面波器件来说,对温度非常敏感。在较高温度下,衬底材料的硬度易于下降,声波速度也因此下降。由于保护频带越来越窄,并且消费设备的指定工作温度范围较大(通常为-20℃至85℃),因此这种局限性的影响越来越严重。
一种替代方法是使用温度补偿(TC-SAW)滤波器,它是在IDT的结构上另涂覆一层在温度升高时刚度会加强的涂层。温度未补偿SAW器件的频率温度系数(TCF)通常约为-45ppm/℃,而TC-SAW滤波器则降至-15到-25ppm/℃。但由于温度补偿工艺需要加倍的掩模层,所以,TC-SAW滤波器更复杂、制造成本也相对更高。
目前TC-SAW技术越来越成熟,国外大厂基本都有推出相应产品,在手机射频前端取得不少应用,而国内的工艺仍需要摸索。
二、高频SAW
普通SAW基本上是2GHz以下,村田开发出克服以往声表面波弱点的 I.H.P.SAW(Incredible High Performance-SAW)。村田意将SAW技术发挥到极致(4GHz以下),目前量产的频率可达3.5GHz。
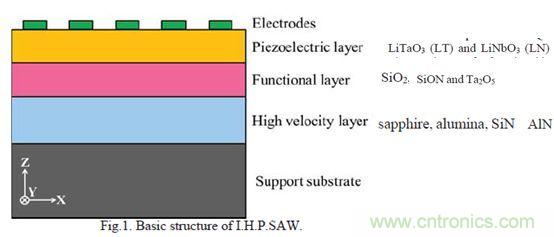
图I.H.P.SAW的基本结构
I.H.P.SAW可以实现与BAW相同或高于BAW的特性,并兼具了BAW的温度特性、高散热性的优点,具体如下:
(1) 高Q值:在1.9GHz频带上的谐振器试制结果显示,其Q值特性的峰值超过了3000,比以往Qmax为1000左右的SAW得到了大幅度的改善。
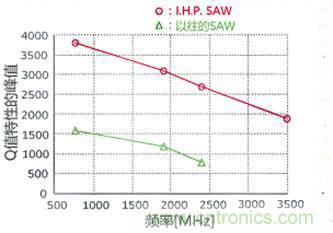
(2)低TCF:它通过同时控制线膨胀系数和声速来实现良好的温度特性。以往SAW的TCF转换量非常大(约为-40ppm/℃),而 I.H.P.SAW可将其改善至±8ppm/℃以下。
(3)高散热性:向RF滤波器输入大功率信号后IDT会产生热量,输入更大功率则可能因IDT发热而破坏电极,从而导致故障。 I.H.P.SAW可将电极产生的热量高效地从基板一侧散发出去,可将通电时的温度上升幅度降至以往SAW的一半以下。低TCF和高散热性两种效果,使其在高温下也能稳定工作。
三、新型体声波滤波器
目前市面上的体声波滤波器基本上基于多晶薄膜工艺。而初创公司Akoustis Technologies, Inc.发明的Bulk ONE? BAW技术是采用单晶AlN-on-SiC谐振器,据称性能能够提升30%。
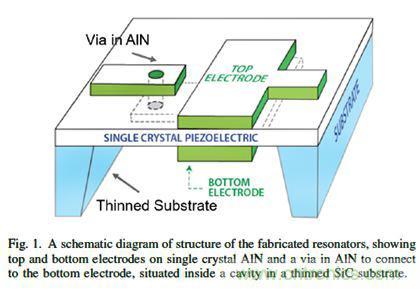
图单晶硅BAW技术针对高频应用
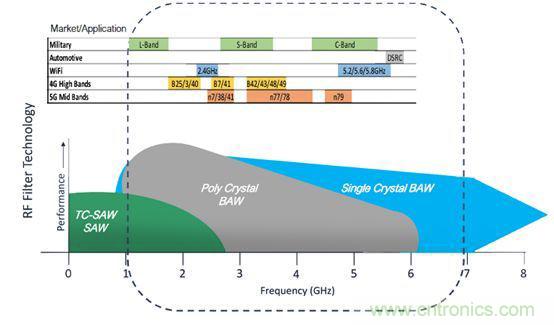
Akoustis技术公司(前称为Danlax,Corp.)是根据美国内华达州法律于2013年4月10日注册成立,总部设在北卡罗来纳州的亨茨维尔。2015年4月15日,公司更名为Akoustis技术公司。2017年3月,登陆纳斯达克。
目前Akoustis已经宣布推出了三款商用滤波器产品:第一款是用于三频WiFi路由器应用的商用5.2 GHz BAW RF滤波器;第二款是针对雷达应用的3.8 GHz BAW RF滤波器;第三款AKF -1652是针对未来4G LTE和5G移动设备5.2 GHz BAW RF滤波器
四、封装微型化
滤波器的封装微型化主要是指的是采用晶圆级封装技术。
Qorvo的CuFlig互联技术使用铜柱凸点代替线焊。晶圆级封装滤波器取消了陶瓷封装,可以实现尺寸更小,设备更轻薄。
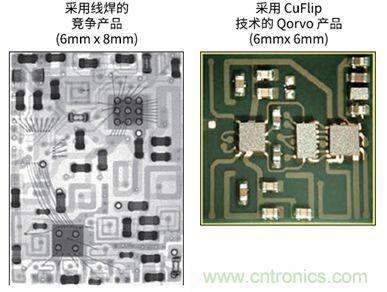
图CuFlip技术相对于线焊的比较优势
RF360公司DSSP(Die-Sized SAW Packaging,裸片级声表封装)和TFAP技术(Thin-Film Acoustic Packaging,薄膜声学封装技术),实现了产品微型化,并可提供2in1,甚至4in1的滤波器模组。
不同产品类别的新的标准封装尺寸:双工器1.8mm*1.4mm,2in1滤波器:1.5mm*1.1mm,单一滤波器:1.1mm*0.9mm。
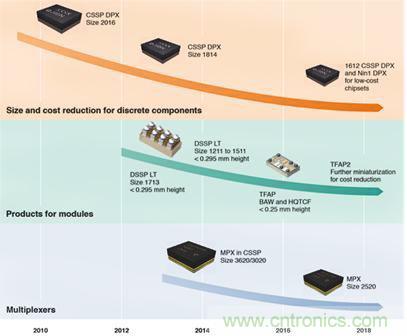
图RF360声表滤波器、双工器和多工器的微型化
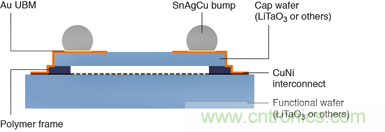
图 DSSP封装图解
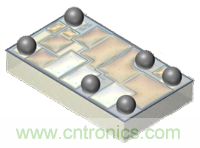
图 采用TFAP技术的BAW滤波器
五、射频前端集成化模块化
国际大厂一直致力于射频前端的集成化及模块化,比如高通RF360方案;Murata将滤波器、RF开关、匹配电路等一体化的模块;Qorvo RF Fusion解决方案等。
高通POP3D设计采用先进的3D封装技术,单一封装内集成了单芯片多模功率放大器和天线开关(AS),并将滤波器和双工器集成到一个单一基底中,然后将基底置于基础组件之上,整合成一个单一的“3D”芯片组组合,从而降低了整体的复杂性,摒弃了当今射频前端模块中常见的引线接合。
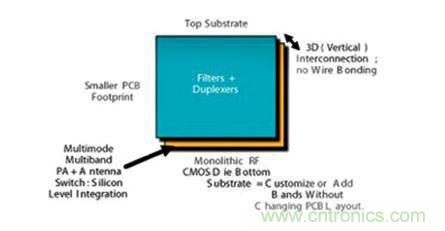
图高通射频POP 3D设计CMOS前端
Qorvo RFFusion解决方案包含三种模块化解决方案,实现高、中、低频段频谱区域全覆盖。各模块都集成了功率放大器 (PA)、开关和滤波器。
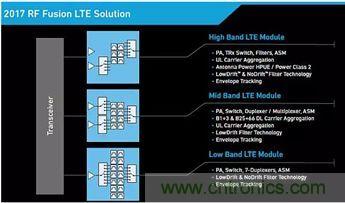
图 Qorvo 多模块组成的 2017 RF Fusion解决方案




