【导读】我们有能力创造一些能保持前代性能并且更好更小的电子设备,例如今天的可穿戴设备、智能手机或平板电脑,这是由于很多因素超过摩尔定律而快速发展,从而能够从底层的嵌入组件发展到今天把它们封装在一起。关于后者,扇出晶圆级封装(FOWLP)正在迅速成为新的芯片和晶圆级封装技术,并被预测会成为下一代紧凑型,高性能的电子设备的基础。
我们有能力创造一些能保持前代性能并且更好更小的电子设备,例如今天的可穿戴设备、智能手机或平板电脑,这是由于很多因素超过摩尔定律而快速发展,从而能够从底层的嵌入组件发展到今天把它们封装在一起。关于后者,扇出晶圆级封装(FOWLP)正在迅速成为新的芯片和晶圆级封装技术,并被预测会成为下一代紧凑型,高性能的电子设备的基础。
而用常规的倒装芯片 WLP 方案中 I/O 端子散布在芯片表面面积,从而限制了 I/O 连接的数目,FOWLP 在一个环氧模制化合物(EMC)中嵌入每个裸片时,每个裸片间的空隙有一个额外的 I/O 连接点,这样 I/O 数会更高并且的对硅利用率也有所提高。再分布层(RDLs)由物理气相沉积(PVD)形成,并和随后的电镀以及微影图案,重新规划从裸片上的 I/O 链接到外围环氧树脂区域的路线。
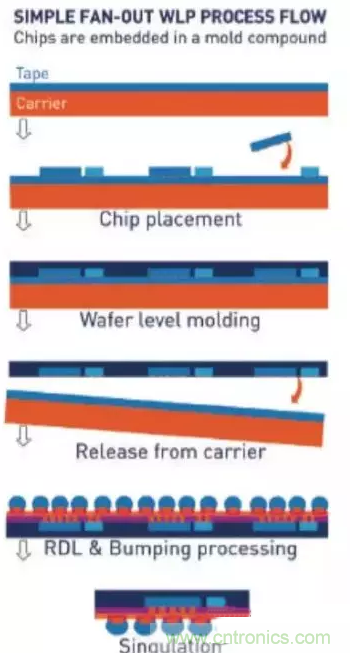
图 1 农村配网和住宅小区
FOWLP 处理流程
利用 FOWLP,具有成千上万 I/O 点的半导体器件可通过两到五微米间隔线实现无缝连接,从而使互连密度最大化,同时实现高带宽数据传输。去除基板显著节约了成本。
伴随 FOWLP,如今我们才有能力在这些模片上嵌入一些异构设备包括基带处理器,射频收发器和电源管理 IC,从而实现了最新一代的超薄可穿戴和移动无线设备。因为不间断的线和节约的空间,FOWLP 有潜力适用于更高性能的设备,包括内存和应用处理器,FOWLP 能够应用到新的市场,包括汽车和医疗应用甚至更多。
今天业内领先的 FOWLP 应用产商包括了 Amkor, ASE, Freescale, NANIUM, STATS ChipPAC, 和台积电,台积电由于其广泛报道的与苹果公司生产 iphone7 的 a10 处理器的合同,成为最受注目的供应商 – 据说此部分归功于台积电成熟的基于 FOWLP 的 inFO 技术。
据研究公司 YoleDéveloppement 公司于 2015 年 9 月发布的名为“FO WLP Forecast update 09/2015”的报道,台积电发布的 inFO 格式有望把 FOWLP 的工业封装收益从 2015 年的$ 240M 在 2020 年增至$ 2.4B。随着预期的 54%复合年增长率,Yole 预计 FOWLP 将成为半导体工业里发展最快的先进封装技术。
发热量低,高速处理
所有扇出晶圆以单裸片嵌入 EMC 为特征,旋转介质围绕着 RDL。这些材料呈现一些独有的问题,包括吸湿性,过量放气和有限的耐热性。如果不妥善处理,在金属沉积阶段的污染会危及接触电阻。
而传统的硅电路可承受的热量高达 400℃,可以在一分钟内进行脱气。FOWLP 中使用的介质和 EMC 耐热性接近 120℃,温度超过这个阈值会导致分解和过度晶圆翘曲。在这样低的温度下脱气晶片,自然需要较长的时间量,并且大大减少了常规的溅射系统的吞吐量。
多晶片脱气(MWD)的技术已经成为一个引人注目的解决方法,在晶片单独转移到后续的预清洁和溅射沉积之前,高达 75 个的晶片可以并行在 120℃下脱气,而不会破坏真空状态。
用这种方法,晶片被动态地在干净,高度真空条件下泵浦,将加热晶片的辐射热直接传递给低于封装应用规定的温度
在 MWD 内每个晶片所花时间达到 30 分钟,但因为它们是并行处理的,“干”晶片每 60 至 90 秒输出进入到金属沉积,每小时晶片输出数在 30 到 50 之间。相比于单晶片脱气技术,此方法使 PVD 系统流量增大 2-3 倍。基于钝化厚度增加的更低热预算的材料出现,更长时间的脱气对系统容量不会产生影响。
这些好处是不容易实现的,除非我们能够克服随之而来的翘曲挑战。环氧模晶片可以在固化后翘曲,翘曲的尺寸和形状是由嵌入晶片的位置、晶片形状和密度决定的。因此,一个 FOWLP PVD 系统必须能够使化温度引起的形状变化达到最小,和能够容纳弯曲度达 10mm 的晶片。工业中对于可接受的弯曲阈值可能低于 6mm,但是,在一个 6mm+翘曲的基板上完成均匀厚度的导体是不太容易。
完整至上
成功脱气后,但在金属沉积之前,FO 晶片在等离子体蚀刻模块中预清洁。这有助于从触头去除微量氧化物层,但是由于触头周围的有机介质的混合物,将导致碳堆积于室壁。这些碳不易粘附到陶瓷腔室的表面,并且如果不仔细管理,可能会导致早期颗粒破裂。
新原位粘贴技术使这些沉积碳在预清洗过程中更好地吸附在室表面,实现超过 6000 片晶圆的保护性间隔维持。这种方法可以通过减少专用晶片糊剂的频率,大大提高产量。使用传统技术,每生产 10 至 20 个晶片就要为室粘贴而暂停生产。
FOWLP 对于超小型、高 I/O 电子设备的好处,比主流 FOWLP 所面临的上述技术壁垒要重要的多。有了克服阻碍 FOWLP 工艺的脱气,翘曲和完整性这些困难的能力,电子产品制造商可以消除影响生产速度和产率的阻力,同时释放 FOWLP 的全部潜力。




