【导读】在DRAM结构中,电容存储单元的充放电过程直接受晶体管所控制。随着晶体管尺寸缩小接近物理极限,制造变量和微负载效应正逐渐成为限制DRAM性能(和良率)的主要因素。而对于先进的DRAM,晶体管的有源区 (AA) 尺寸和形状则是影响良率和性能的重要因素。
在DRAM结构中,电容存储单元的充放电过程直接受晶体管所控制。随着晶体管尺寸缩小接近物理极限,制造变量和微负载效应正逐渐成为限制DRAM性能(和良率)的主要因素。而对于先进的DRAM,晶体管的有源区 (AA) 尺寸和形状则是影响良率和性能的重要因素。在本研究中,我们将为大家呈现,如何利用SEMulator3D研究先进DRAM工艺中存在的AA形状扭曲和与之相关的微负载效应与制造变量。
AA扭曲及其机理
领先DRAM制造商几乎所有已商业化的DRAM产品都存在AA形状扭曲。除中心线不稳定以外,这种扭曲还体现在切割区域周边的关键尺寸差异(见图1)。
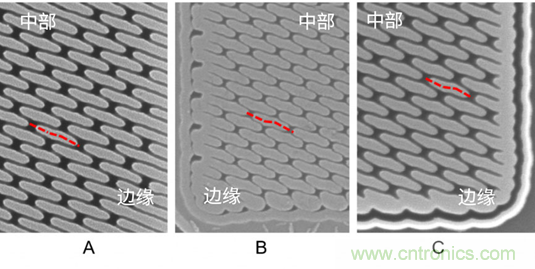
图1. 三家不同制造商生产的1x DRAM器件的AA剖面图
图2为晶体管鳍片刻蚀工艺的简要示意图。在鳍片 (AA) 干法刻蚀工艺中,侧壁会因刻蚀副产物的钝化作用而出现锥形轮廓。由于A点所处区域需要去除的硅要多于B点所处区域,A区域消耗的反应物更多,产生的副产物也会更多(见图2 (b))。这样,在鳍片刻蚀后,A区域侧壁的钝化锥度就要超过B区域的侧壁(见图2 (c)),这也就是AA形状扭曲的原因。
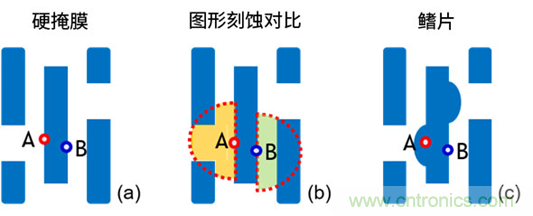
图2. 鳍片刻蚀工艺中的AA形状扭曲 (a) 刻蚀前硬掩膜的顶视图;(b) A、B两区域的图形刻蚀对比;(c) 鳍片刻蚀后的顶视图
AA扭曲的建模
SEMulator3D采用创新的伪3D方法,实现基于2D迫近函数的图形建模。通过这种建模技术,我们可以创建DRAM器件的3D模型并模拟出AA形状扭曲现象。图3展示的是通过SEMulator3D模拟的DRAM 3D结构和平面图、布局设计和图形相关掩膜。通过对比可以看出,图3 (d) 和图1 (c) 所呈现的AA扭曲形态是类似的,这证明模型能正确反映实际制造结果。图4展示的是不同鳍片高度的AA剖面图,从中可以看出结构底部的扭曲幅度要远高于器件顶部的扭曲。
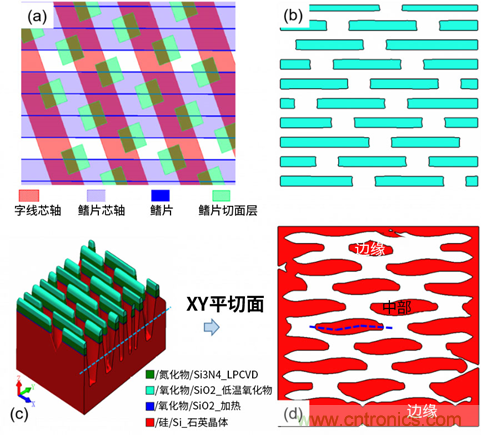
图3. (a) 布局设计;(b) 硬掩膜生成的PDE掩膜;(c)鳍片刻蚀后的3D结构;(d)来自鳍片中部平面切口的AA形状
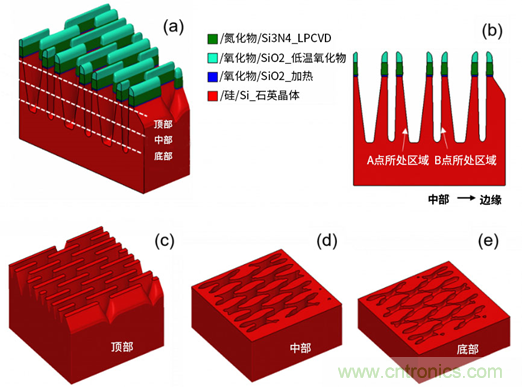
图4. 不同鳍片高度的AA剖面 (a) 沿字线切开的3D视图;(b) 沿字线切开的横截面图;(c) 沿鳍片顶部切开的3D视图;(d)沿鳍片中间切开的3D视图;(e) 沿鳍片底部切开的3D视图
器件模拟与分析
在具有埋入式字线的DRAM单元中,晶体管通道位于鳍片中部附近,这里的形状扭曲要比鳍片顶部严重(见图4 (c)和 (d))。在这种情况下,受侧壁钝化的影响,该通道下方的鳍片CD也要大很多。
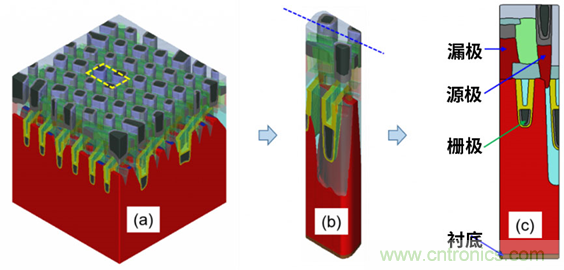
图5. 电容接触点形成后的DRAM结构 (a) 3D视图;(b)切出的单器件;(c)鳍片切面和端口定义
为评估AA形状扭曲对器件性能的影响,我们用SEMulator3D建模了0.1、2.5和5度的侧壁裂角以模拟不同程度的AA扭曲,并使用来自全环路DRAM结构的单个器件进行了电气分析(见图5 (b))。通过SEMulator3D分配电端口(源极、漏极、栅极和衬底)即可获得电气测量值(见图5 (c)),之后使用SEMulator3D内置漂移/扩散求解器即可计算不同程度AA扭曲可能导致的电气性能变化。
图6展示的是不同侧壁角度下鳍片的断态漏电流分布。可以看出,无论侧壁角度如何,大部分漏电流集中在鳍片的中心,它们远离栅极金属,栅极电场对其没有太大影响。由于厚鳍(侧壁角度较大)的栅极可控性更低,其漏电流密度要远高于更薄的鳍片。
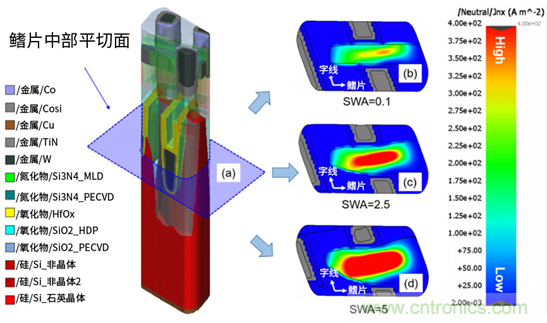
图6. 从鳍片表面到中心在不同侧壁角度下的通道泄漏形态
总结
本研究使用SEMulator3D建模和分析了先进DRAM工艺中的晶体管微负载效应。分析结果表明,图形相关刻蚀中的微负载效应会导致AA形状扭曲,这种微负载效应将严重影响器件的电气性能,其中涉及的断态泄漏更是决定DRAM单元数据保留能力的关键因素。
免责声明:本文为转载文章,转载此文目的在于传递更多信息,版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请电话或者邮箱联系小编进行侵删。




