【导读】节能、高效、低碳、体积小、反应快、抗震性强等优点,使得LED为用户提供环保、稳定、高效和安全的全新照明体验。LED的发展势不可挡,可是话说LED是如何“打造”的呢?这里就详解LED打造过程:倒装技术及工艺流程。
倒装LED技术的发展及现状
倒装技术在LED领域上还是一个比较新的技术概念,但在传统IC行业中已经被广泛应用且比较成熟,如各种球栅阵列封装(BGA)、芯片尺寸封装(CSP)、晶片级芯片尺寸封装(WLCSP)等技术,全部采用倒装芯片技术,其优点是生产效率高、器件成本低和可靠性高。
倒装芯片技术应用于LED器件,主要区别于IC在于,在LED芯片制造和封装过程中,除了要处理好稳定可靠的电连接以外,还需要处理光的问题,包括如何让更多的光引出来,提高出光效率,以及光空间的分布等。
针对传统正装LED存在的散热差、透明电极电流分布不均匀、表面电极焊盘和引线挡光以及金线导致的可靠性问题,1998年,J.J.Wierer等人制备出了1W倒装焊接结构的大功率AlGaInN-LED蓝光芯片,他们将金属化凸点的AIGalnN芯片倒装焊接在具有防静电保护二极管(ESD)的硅载体上。
图1是他们制备得到的LED芯片的图片和截面示意图。他们的测试结果表明,在相同的芯片面积下,倒装LED芯片(FCLED)比正装芯片有着更大的发光面积和非常好的电学特性,在200-1000mA的电流范围,正向电压(VF)相对较低,从而导致了更高的功率转化效率。
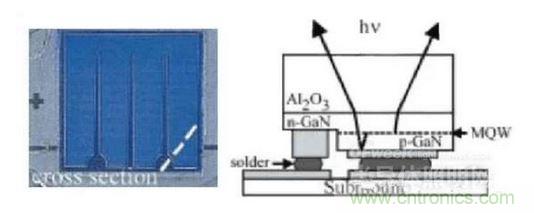
图1 倒装结构的LED芯片图片和截面示意图
2006年,O.B.Shchekin等人又报道了一种新的薄膜倒装焊接的多量子阱结构的LED(TFFC-LED)。所谓薄膜倒装LED,就是将薄膜LED与倒装LED的概念结合起来。
在将LED倒装在基板上后,采用激光剥离(Laser lift-off)技术将蓝宝石衬底剥离掉,然后在暴露的N型GaN层上用光刻技术做表面粗化。
如图2所示,这种薄膜结构的LED可以有效地增加出光效率。但相对来说,这种结构工艺比较复杂,成本会相对较高。
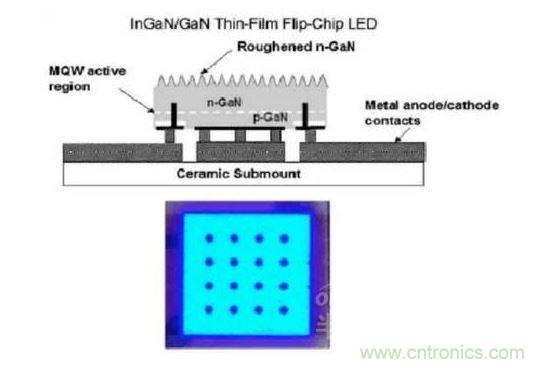
图2 薄膜倒装LED芯片结构示意图
随着硅基倒装芯片在市场上销售,逐渐发现这种倒装LED芯片在与正装芯片竞争时,其成本上处于明显的劣势。
[page]
由于LED发展初期,所有封装支架和形式都是根据其正装或垂直结构LED芯片进行设计的,所以倒装LED芯片不得不先倒装在硅基板上,然后将芯片固定在传统的支架上,再用金线将硅基板上的电极与支架上的电极进行连接。
使得封装器件内还是有金线的存在,没有利用上倒装无金线封装的优势;而且还增加了基板的成本,使得价格较高,完全没有发挥出倒装LED芯片的优势。
为此,最早于2007年有公司推出了陶瓷基倒装LED封装产品。这一类型的产品,陶瓷既作为倒装芯片的支撑基板,也作为整体封装支架,实现整封装光源的小型化。
这一封装形式是先将倒装芯片焊接(Bonding)在陶瓷基板上,再进行荧光粉的涂覆,最后用铸模(Molding)的方法制作一次透镜,这一方法将LED芯片和封装工艺结合起来,降低了成本。
这种结构完全消除了金线,同时散热效果明显改善,典型热阻<10℃/W,明显低于传统的K2形式的封装(典型10-20℃/W)。
随着倒装技术的进一步应用和发展,2012年开始,出现了可直接贴装(Direct Attach,DA)倒装芯片;随后几年,各个公司都开始研发和推出这一类型的倒装芯片。
该芯片在结构上的变化是,将LED芯片表面的P、N两个金属焊盘几何尺寸做大,同时保证两个焊盘之间的间距足够,这样使得倒装的LED芯片能够在陶瓷基板上甚至是PCB板上直接贴片了,使40mil左右的倒装芯片焊盘尺寸能够到达贴片机的贴片精度要求,简化了芯片倒装焊接工艺,降低了整体成本。
至目前为止(2014年中)倒装DA芯片已基本成熟,市场销售量逐步增加,未来将会成为大功率LED芯片的主流。
在直接贴装DA芯片基础上,2013年开始发展出了白光芯片(部分公司称为免封装或无封装)产品,如图6所示。它是在倒装DA芯片制造过程中同时完成了荧光粉的涂敷,应用时可在PCB上直接进行贴片,完全可以当作封装光源直接应用。
其优势是LED器件体积小,芯片直接贴片可以减少散热的界面,进一步降低了热阻,散热性能进一步提高。到目前为止,白光芯片仍然处于研发阶段,市场的应用还不成熟,需要大家共同努力,推动白光芯片技术和应用的发展。

图3 白光芯片与封装示意图
倒装LED芯片的制作工艺
倒装LED芯片的制作工艺流程,如图4所示,总体上可以分为LED芯片制作和基板制造两条线,芯片和基板制造完成后,将LED芯片倒装焊接在基板表面上,形成倒装LED芯片。
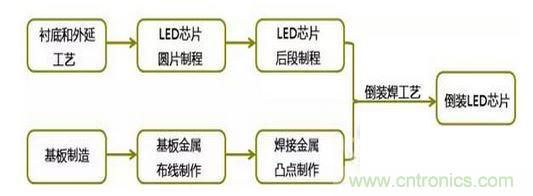
图4 倒装LED芯片工艺流程框图
[page]
1、蓝宝石衬底和GaN外延工艺技术
对于倒装芯片来说,出光面在蓝宝石的一侧,因此在外延之前,制作图形化的衬底(PSS),将有利于蓝光的出光,减少光在GaN和蓝宝石界面的反射。因此PSS的图形尺寸大小、形状和深度等都对出光效率有直接的影响。在实际开发和生产中需要针对倒装芯片的特点,对衬底图形进行优化,使出光效率最高。
在GaN外延方面,由于倒装芯片出光在蓝宝石一侧,其各层的吸光情况与正装芯片有差异,因此需要对外延的缓冲层(Buffer)、N-GaN层、多层量子阱(MQW)和P型GaN层的厚度和掺杂浓度进行调整,使之适合倒装芯片的出光要求,提高出光效率,同时适合倒装芯片制造工艺的欧姆接触的需要。
2、倒装LED圆片制程工艺
倒装芯片与正装芯片的圆片制作过程大致相同,都需要在外延层上进行刻蚀,露出下层的N型GaN;然后在P和N极上分别制作出欧姆接触电极,再在芯片表面制作钝化保护层,最后制作焊接用的金属焊盘,其制作流程如图5所示。

图5 倒装LED圆片制作流程
与正装芯片相比,倒装芯片需要制作成电极朝下的结构。这种特殊的结构,使得倒装芯片在一些工艺步骤上有特殊的需求,如欧姆接触层必须具有高反射率,使得射向芯片电极表面的光能够尽量多的反射回蓝宝石的一面,以保证良好的出光效率。
倒装芯片的版图也需要根据电流的均匀分布,做最优化的设计。由于圆片制作工艺中,GaN刻蚀(Mesa刻蚀)、N型接触层制作、钝化层制作、焊接金属PAD制作都与正装芯片基本相同,这里就不详细讲述了,下面重点针对倒装芯片特殊工艺进行简单的说明。
在LED芯片的制作过程中,欧姆接触层的工艺是芯片生产的核心,对倒装芯片来说尤为重要。欧姆接触层既有传统的肩负起电性连接的功能,也作为反光层的作用,如图9所示。
在P型欧姆接触层的制作工艺中,要选择合适的欧姆接触材料,既要保证与P型GaN接触电阻要小,又要保证超高的反射率。此外,金属层厚度和退火工艺对欧姆接触特性和反射率的影响非常大,此工艺至关重要,其关系到整个LED的光效、电压等重要技术参数,是倒装LED芯片工艺中最重要的一环。
[page]
目前这层欧姆接触层一般都是用银(Ag)或者银的合金材料来制作,在合适的工艺条件下,可以获得稳定的高性能的欧姆接触,同时能够保证欧姆接触层的反射率超过95%。
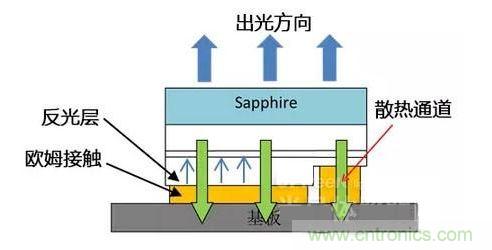
图6 倒装芯片出光方向、散热通道、欧姆接触、反光层位置示意图
3、倒装LED芯片后段制程
与正装LED芯片一样,圆片工艺制程后,还包括芯片后段的工艺制程,其工艺流程如图7所示,主要包括研磨、抛光、切割、劈裂、测试和分类等工序。这里工序中,唯一有不同的是测试工序,其它工序基本与正装芯片完全相同,这里不再赘述。

图7 LED芯片后段工艺制程流程图
倒装芯片由于出光面与电极面在不同方向,因此在切割后的芯片点测时,探针在LED正面电极上扎针测量时,LED的光是从背面发出。要测试LED的光特性(波长、亮度、半波宽等),必须从探针台的下面收光。
因此倒装芯片的点测机台与正装点测机台不同,测光装置(探头或积分球)必须放在探针和芯片的下面,而且芯片的载台必须是透光的,才能对光特性进行测试。
所以,倒装芯片的点测机台需要特殊制造或改造。






