【导读】预计到2020年,5G应用支持的频段数量将实现翻番,新增50个以上通信频段,全球2G/3G/4G/5G网络合计支持的频段将达到91个以上,这将推动射频(RF)滤波器产业大爆发。麦姆斯咨询近日探访了苏州捷研芯位于东景工业坊的国内首条SAW滤波器封装代工产线,并对捷研芯副总经理王建国进行了简短访谈。

无线通信频段增加带动滤波器市场快速增长,考虑物联网接入、其他新的近场连接方式,滤波器需求还将增大。滤波器在射频前端芯片中的应用范围十分广泛,双工器(Duplexer)和多工器(Multiplexer)内部的核心器件也是声表面波滤波器(SAW)和体声波滤波器(BAW),随着移动通信模式和频段的增加,数量增长最快的射频前端器件便是滤波器。据麦姆斯咨询报道,滤波器已成为射频前端市场中最大的业务板块,2016~2022年期间其复合年增长率将达21%,市场规模将从2016年的52亿美元增长至2022年的163亿美元。
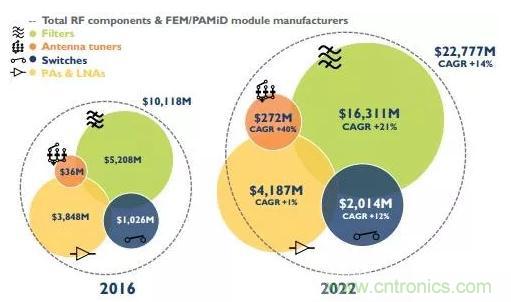
2016~2022年手机射频前端模块和组件市场
数据来源:《手机射频前端模块和组件-2017版》
市场格局:RF滤波器市场被日本和欧美垄断,高端国产化率几近为零,低端只占全球供应量的1%到3%!
从全球范围来看,SAW滤波器的主要供应商包括TDK-EPCOS、Murata(村田)和太阳诱电,三者合计占据了全球82%的市场份额。BAW滤波器的主要供应商包括Avago及Qorvo(Triquint),两者占据了全球95%以上的市场份额。

产业现状:国外技术垄断,国内刚刚起步
美国厂商Avago、Qorvo、Skyworks和日本厂商TDK、村田、太阳诱电为主要厂商。其中美国厂商多具备提供前端模块解决方案和提供BAW滤波器的能力,日本厂商以SAW滤波器为主,日本富士通、三洋电器、丰田等少数几家掌握压电基片生产技术的制造商垄断了世界SAW滤波器市场。2020年国内滤波器市场有望超200亿元,但目前相关厂商有所缺失,具备技术的主要是科研院所和目前一些供货量尚不大的IDM厂商,国内几家A股上市公司和大型设计企业,尤其是在PA领域取得突破的设计公司正在积极布局滤波器领域。
SAW滤波器的微型化、高可靠、低成本和集成化是大势所趋,对SAW滤波器而言,芯片设计和流片相对简单,设计和流片费用相比传统的IC芯片要便宜得的多,但是需要一个长期的积累过程。由于其空腔结构形成于封装阶段,滤波器的性能和可靠性更多的依赖于封装技术。
封装技术趋势:小型片式化发展(CSP)
SAW器件封装要求:(1)器件有源表面必须有一定空间;(2)衬底和封装材料必须有良好的热匹配;(3)防止湿气浸人和微粒沾污。先后经历过气密金属封装、塑料封装、陶瓷封装、陶瓷倒装焊、芯片尺寸级声表封装CSSP等几个阶段,针对不同的客户需求和应用场景这些封装方案依然共存,但是器件的小型化是大势所趋。

SAW封装方法进化图
为使SAW小型化发展通常采取三种措施:
1)优化设计器件用芯片,设法使其做得更小;
2)改进器件的封装形式,现在已经由传统的圆形金属壳封装改为方形或长方形扁平金属封装或LCCC(无引线陶瓷芯片载体)表面贴装的形式,采用体积更小的CSP封装形式,目前封装尺寸已做到1.1mm x 0.9mm;
3)将不同功能的SAW滤波器封装在一起,构成组合型器件以减小占用PCB的面积。
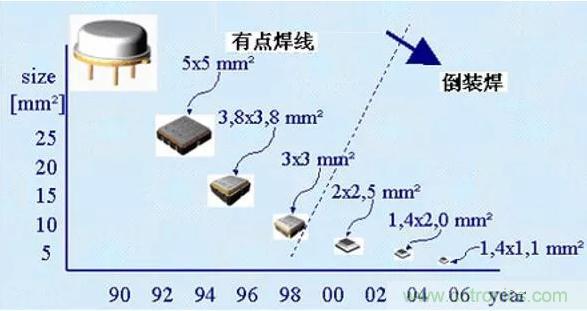
小型片式化发展
捷研芯小型化RF滤波器封装技术:金球倒装真空覆膜成腔技术
金球倒装技术在高端器件上的应用比较多,尤其在日本应用非常广泛,苏州捷研芯纳米科技有限公司(以下简称捷研芯)经过两年多的技术研发、积累和布局,于2018年5月建成了我国第一条专业的金球倒装RF滤波器代工线,率先推出批量代工业务!
芯片倒装互连技术是在芯片焊盘上作凸点,然后将芯片倒扣于基板进行凸点与基板间的连接,凸点连接比引线键合连线短,传输速度高,其可靠性提高30~50倍,当前的回流焊倒装可靠性比较高,而且凸点数量多,采用Sn/Pb焊料,对环境及人体的保护极为不利,且回流焊凸点通过刻蚀形成,工艺复杂,成本高,回流焊凸点的电阻率达22μΩ/cm。
另外,因为很多芯片本身具有特殊的结构和感应材料,限制了很多芯片采用这种互联方式,比如MEMS传感器、生物检测芯片、有机材料感光光学类、通讯类、医疗类等。而金凸点比回流焊凸点的导电、导热性能比回流倒装高10倍,金为较软金属,当前业界已开始采用热压超声倒装键合完成金凸点互连,应用于I/O数量较少的芯片封装,其金球倒装工艺简单、成本低、绿色环保,已显示出独特的技术优势和前景。
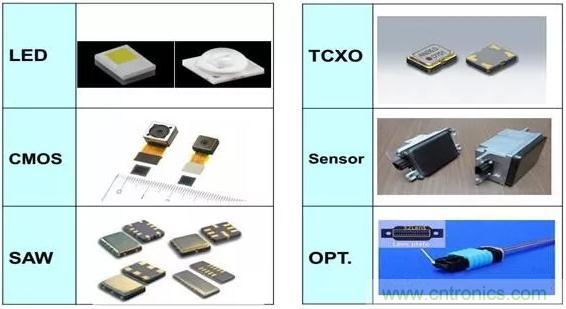
金球倒装技术的应用领域
以SAW滤波器为例,金球倒装真空覆膜成腔技术具有低成本、高性能、微型化和高效率特点,约70%的SAW产品采用金球倒装技术。
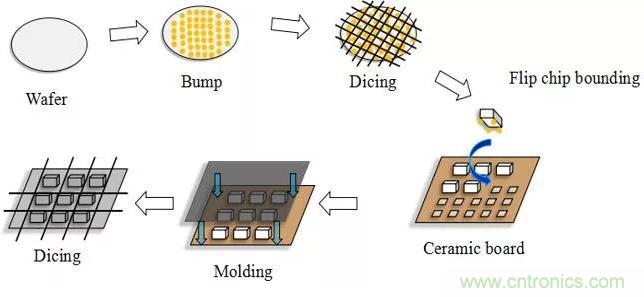
工艺流程
芯片边缘留给封装的空间只有200μm,UBM直径90μm,芯片厚度150~200μm,整体封装厚度<550μm。由于是非气密封装芯片上需镀有一层薄的无机钝化层,以防止铝结构发生腐蚀。

麦姆斯咨询近日探访了苏州捷研芯位于东景工业坊的国内首条SAW滤波器封装代工产线,并对捷研芯副总经理王建国进行了简短访谈:
麦姆斯咨询:王总,您好!请简单介绍一下目前捷研芯在SAW滤波器封装方面的技术成熟度和主要业务进展。
王建国:目前捷研芯已服务业内客户近10家,封装的工艺技术不仅经过了样品的检验,且完成了多批小量产,主要工艺过程能力CPK均大于1.33;按JEDEC可靠性实验标准进行了湿气敏感性测试、高低温冲击、双85老化实验、高温保存寿命实验等,实验结果优异,满足可靠性要求。另外,捷研芯在封装成本降低方面也做了诸多的研发和验证。
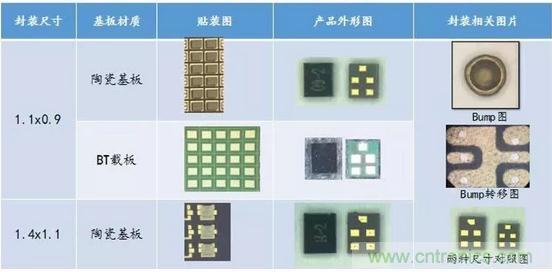
CSP小型化SAW产品示例

封装过程数据分析

可靠性实验
麦姆斯咨询:捷研芯目前的产能状况及未来的产能计划是怎样的?除了SAW滤波器封装线以外,捷研芯3000余平的东景工业坊工厂还主要做哪些封装代工业务?
王建国:基于目前的市场情况,捷研芯首条SAW滤波器代工线产能是5KK/月,打样产能充足。我们已经在做规模化的产能扩充计划,根据市场需求,将随时启动扩产。
捷研芯MEMS和传感器封装能力
- OEM+ODM方案开发满足新型MEMS传感器的多样化的封装要求;
- 拥有BT基板封装、带腔体封装、高压塑封、低应力封装、陶瓷封装、3D微组装、金球倒装互联等封装技术;
- RF声表滤波器、硅麦克风、MEMS喷墨头、气体类传感器、压力、磁传感器和红外光源已批量生产。

捷研芯系统集成微模块封装能力
- SMT+WB+Flip chip+Molding工艺和微组装工艺综合应用;
- 可集成包括MEMS、AISC、IC和无源器件等的高密度工业级塑封器件;
- 集成MEMS传感器、集成电源模块、低功耗控制模块、RF射频前端已具批量生产能力。

麦姆斯咨询:相比国内大型的OSAT封测代工厂,贵司服务模式有什么差异化优势?
王建国:捷研芯始终专注于MEMS传感器和系统集成微模块的封装、系统集成、边缘计算和组网技术,OEM+ODM相结合,在人工智能结合物联网(AIoT)的大背景下,以“微纳传感器”为核,“异质异构封装”为壳,“软件算法”为智,不仅满足客户的封装需求,而且拓展并陆续推出了模块化、系统化和智能化的系列服务和产品方案。
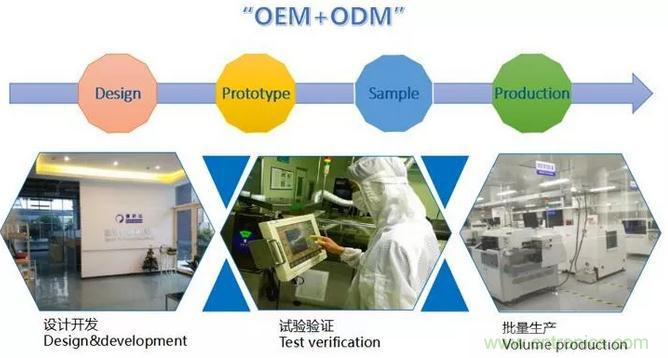
作者: 麦姆斯咨询殷飞




